|
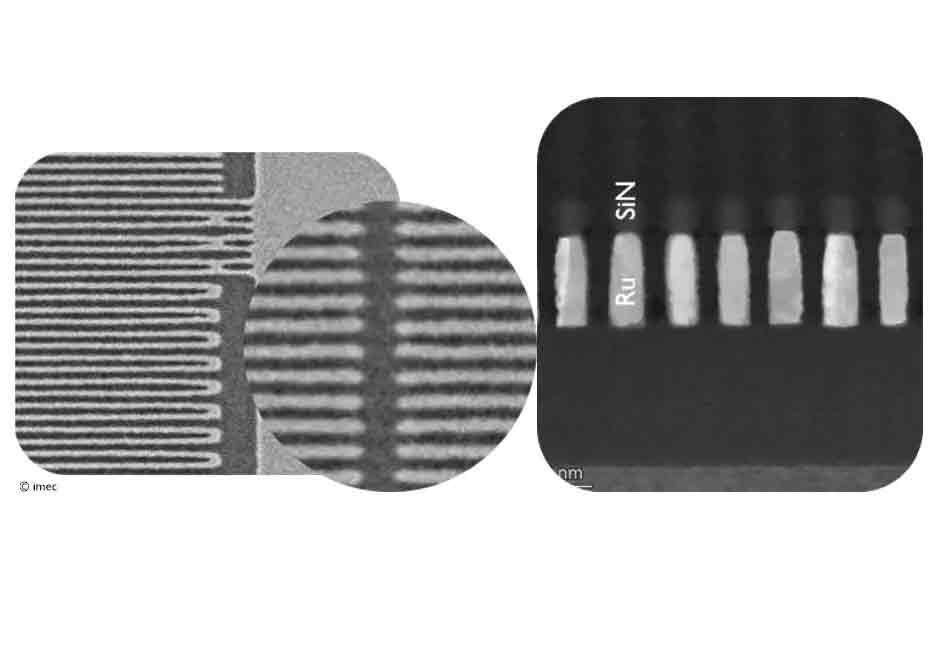
【产通社,9月25日讯】在美国加州举行的“SPIE光掩模技术 + EUV光刻”会议上,AMSL核心合作伙伴――比利时Imec实验室展示了两项单次印刷高数值孔径 EUV光刻技术成果:
1、间距为20nm的线条结构,具有13nm的尖端 CD(临界尺寸),适用于镶嵌金属化工艺。
2、使用直接金属蚀刻(DME)工艺获得的20nm间距和18纳米间距的钌线条。
这两者成果均通过单次印刷高数值孔径(NA)极紫外(EUV)光刻技术获得。对于20纳米间距的DME线条结构,电学测试的良率达到了100%。
Imec副总裁Steven Scheer表示:“ASML-imec高数值孔径EUV联合实验室在费尔德霍芬正式启用后,imec及其合作伙伴生态系统在推动光刻技术发展和推动行业迈入埃时代方面取得了长足进步。此次展示的成果标志着一个新的里程碑,彰显了imec在光刻研发领域的领导地位。”
高数值孔径EUV图案化的重要里程碑
Imec在2月份的SPIE先进光刻和图案技术会议上展示了20nm间距的金属化线结构,本次里程碑式展示不仅标志着高数值孔径EUV图案化单次印刷能力提升的重要里程碑,将推动高数值孔径EUV向大批量生产过渡,解锁2nm以下逻辑技术路线图。
该结果是通过优化金属氧化物抗蚀剂以及底层、照明光瞳形状和掩模获得的。如果要中断金属线,就需要这样的结构,在连接逻辑集成电路中的门时也需要这样的结构。
在不影响功能的情况下,端到端距离将缩小至13纳米及以下,以满足20纳米金属间距逻辑路线图的要求。“我们正在进一步缩小端到端尺寸,并在11纳米工艺上取得令人鼓舞的成果,并将这些结构转移到底层硬掩模中,从而实现真正的镶嵌互连。”
Imec预计,在20nm间距以下需要替代的金属化方案,这就是为什么实验室想要证明钌(Ru)直接金属蚀刻与单次曝光High NAEUV光刻的兼容性。
imec实现了20纳米和18纳米间距的钌线,包括15纳米的尖端结构和低电阻功能互连。对于20纳米间距的金属化线结构,获得了100%的电气测试良率。
EUV光刻技术将迈入埃时代
继2025年2月在SPIE先进光刻与图案技术大会上展示20纳米间距金属化线结构后,imec如今通过单次曝光高数值孔径EUV光刻工艺,实现了20纳米间距线结构,其点对点(T2T)临界尺寸(CD)达到13纳米。
对于13纳米T2T结构,测量结果显示其局部CD均匀性(LCDU)低至3纳米,标志着业界的一个里程碑。该结果采用金属氧化物光刻胶(MOR)获得,并与底层、照明光瞳形状和掩模版选择共同优化。
imec计算系统扩展高级副总裁Steven Scheer表示:“与多重曝光相比,采用单次High NAEUV光刻技术实现这些逻辑设计可减少处理步骤,降低制造成本和环境影响,并提高良率。这些成果支持镶嵌金属化技术,这是互连制造的行业标准。T2T结构是互连层的重要组成部分,因为它们可以中断一维金属轨道。为了满足20纳米金属间距的逻辑路线图,T2T距离预计将缩小到13纳米及以下,同时保持功能性互连。进一步缩小T2T尺寸的开发工作正在进行中,11纳米T2T已取得可喜的成果,并将结构转移到底层硬掩模中,从而实现真正的(双)镶嵌互连。”
为了实现20纳米以下的金属化工艺,业界很可能会转向其他金属化方案。作为第二项成果,imec展示了钌(Ru)直接金属蚀刻(DME)与单次曝光高数值孔径EUV光刻技术的兼容性,实现了20纳米和18纳米间距的钌线,包括15纳米T2T结构和低电阻功能互连。对于20纳米间距的金属化线结构,获得了100%的电测试良率。
Steven Scheer表示:“在荷兰费尔德霍芬(Veldhoven)设立ASML-imec高数值孔径EUV联合实验室后,imec及其合作伙伴生态系统在推进高数值孔径EUV光刻技术方面取得了长足进步,并推动行业迈入埃级时代。此次成果标志着一个新的里程碑,彰显了imec在光刻研发领域的领导地位。imec-ASML将与高数值孔径EUV生态系统(包括领先的芯片制造商、设备、材料和光刻胶供应商、掩模公司以及计量专家)密切合作,持续共同优化高数值孔径EUV光刻和图形化技术,以支持逻辑和存储器的发展路线图。”
查询进一步信息,请访问官方网站 http://www.imec-int.com/en/press。(张怡,产通发布) http://www.imec-int.com/en/press。(张怡,产通发布)
|